ASIA ELECTRONICS INDUSTRYYOUR WINDOW TO SMART MANUFACTURING
ASMPT and IBM to Innovate New Chiplet Packages for AI
ASMPT and IBM extended their collaboration on the joint development of the next advancement of chiplet packaging technologies. Through this agreement, the two companies will work together to advance thermocompression and hybrid bonding technology for chiplet packages. Along this line, they will use ASMPT’s next generation of Firebird TCB and Lithobolt hybrid bonding tools.
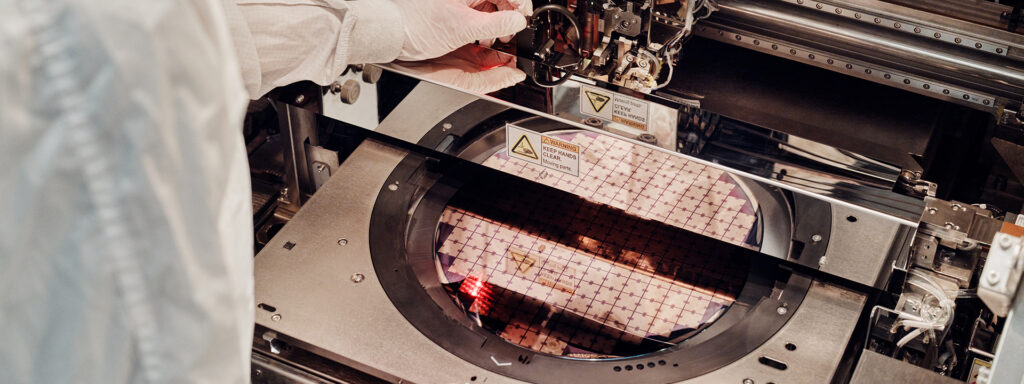
Generally, chiplets deconstruct SOCs into their composite parts. They create smaller chips that can then be packaged together to operate as a single system. Specifically, this aims to provide potential benefits that include improved energy efficiency, faster system development cycle time, and reduced costs. However, packaging advances are necessary to move chiplets from research to mass production more quickly and efficiently. Primarily, this is driven by the rapid pace of innovation in AI computing.
Builds on Existing Collaboration
This latest agreement builds on an existing collaboration between ASMPT and IBM. Primarily, it resulted from the debut of a new hybrid bonding approach* last year. This approach optimizes bonding quality between two chiplets. Now, they will continue to work together on the development of bonding technologies for chiplet packages.
“IBM has been at the forefront of developing advanced packaging technology for the age of AI,” said Huiming Bu, Vice President of IBM Semiconductors Global R&D and Albany Operations, IBM Research. “We are proud to continue our work with ASMPT to advance chiplet packaging technology to pave the way for smaller, more powerful, and more energy-efficient chips.”
Meanwhile, Lim Choon Khoon, Senior Vice President, ASMPT, said, “We are excited to build on our strong relationship with IBM to drive the frontiers of Advanced Packaging in tandem with accelerating innovations in artificial intelligence.”
He added, “We are pleased to work with IBM to advance next-generation packaging and Heterogeneous Integration solutions for the AI era.”
-26 July 2024-




